开启5G新时代——XPS成像技术在半导体器件中的应用

近年来,中国已成为带动全球半导体市场增长的主要动力,随着5G商用牌照落地并在2019年11月份正式使用,会大大推动半导体芯片产业的发展。失效分析对于提高半导体产品质量,技术开发、改进,产品修复及仲裁失效事故等方面具有很强的实际意义。针对半导体器件局部失效分析,可以借助XPS成像技术及微区分析进行表征,岛津XPS配备专利技术的DLD二维阵列延迟线检测器,可以同时记录光电子的信号强度及其发射位置,亦可以在数秒的时间里获取完整的XPS谱图及高能量分辨的化学状态图像。小编带您一起来看看XPS成像技术在半导体器件中的应用实例吧!
实例一:引脚迹斑分析
引脚是指从集成电路(芯片)内部电路引出与外围电路的接线,构成了芯片的接口。随着电子技术的发展,电路板上的器件引脚间距越来越小,器件排列更加密集,电场梯度更大,因此电路板对引脚的腐蚀也变得越来越敏感。如下为一故障铜引脚器件,在AXIS SUPRA仪器腔体显微镜下可看到有一处迹斑(直径~150μm),通过成像技术结合微区分析技术(见图1),可知在该区域额外出现了Cl元素,对比周围区域测试结果,推测该元素的存在是造成腐蚀的主要原因,此外O元素峰强也有所增加,说明该区域氧化现象更为显著。

实例二:“金手指”缺陷区域分析
“金手指”是指电脑硬件如内存条上与内存插槽、显卡与显卡插槽之间等进行电信号传输的介质,金手指涂敷工艺不良或由于使用时间过长导致其表面产成了氧化层,均会导致接触不良,甚至造成器件报废。如下采用XPS分析结合平行成像技术对“金手指”区域及缺陷处进行测试,不同视场成像结果见下图2,亮度越高的区域表示Au元素含量越多。
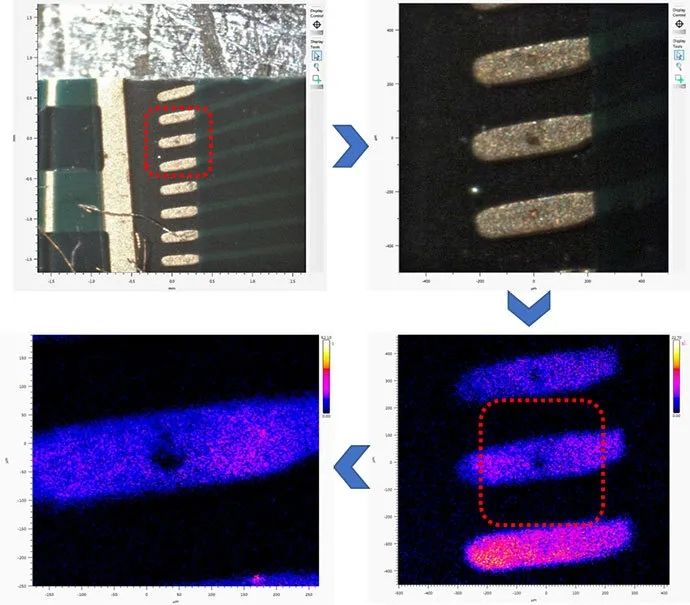
图2 不同视场下的“金手指”样品成像结果
对缺陷部位及显著存在Au元素部位分别进行小束斑选区分析,测试位置见下图3,由测试得到的全谱结果可知,两个区域均存在一定量的F元素;在图像中较亮区域测得结果中,Au元素为主要存在元素,表面C、O元素较少,而缺陷部位测试结果中则只具有少量的Au 4f信号,而C、O、N元素峰较为显著,推测该缺陷部位存在一定的有机物污染。

图3 “金手指”样品缺陷处微区分析结果
选用XPS成像技术对半导体器件微区的表面元素进行分析,可以清楚地了解各元素在器件表面的分布情况,结合污染元素组成及化学状态进行有目的的原因排查,有助于对功能器件的质量控制和失效机制进行把控和解析,有效杜绝污染和器件失效发生,以达到不断对产品工艺和技术进行优化的目的。
上一主题: GDA | 三丰再次荣誉加持
下一主题: “疫”情战役下,在线监测技术助力工业企业复工复产






