WLI白光干涉,探索非接触式3D测量新方式
在半导体、光学元件以及汽车制造等行业的微观制造环节,产品表面形貌与尺寸的精准测定,很大程度上助力了产品性能的稳定保障,也为生产工艺的升级提供了有力支撑。
在此背景下,WLI(白光干涉)技术凭借其高精度、非接触式3D测量这一优势,成为精密测量领域中备受关注的前沿技术之一 。
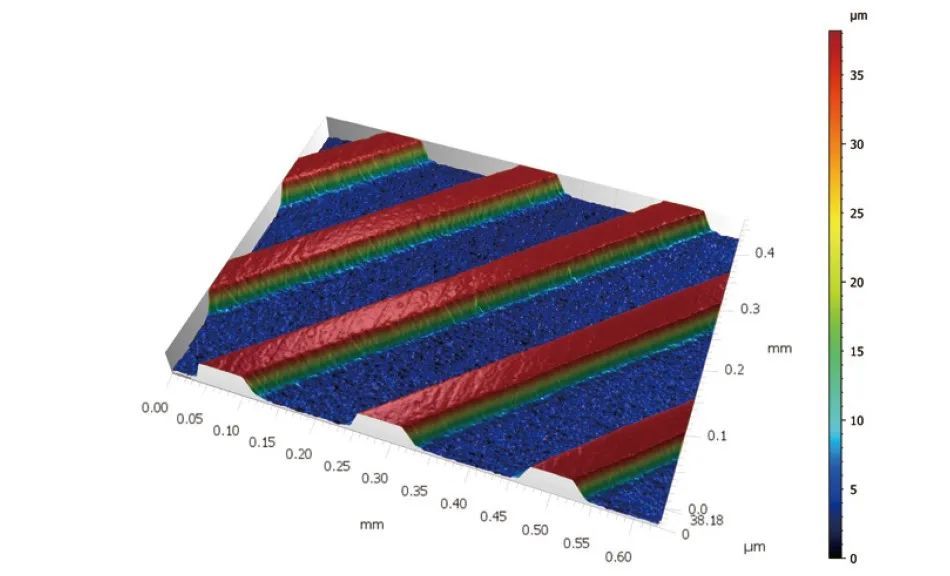
WLI,即 White Light Interferometry,是基于光干涉原理的精密测量技术。它借助光干涉现象,检测被测工件表面形貌的细微起伏或变化,以非接触的方式实现物体表面三维形状测量。
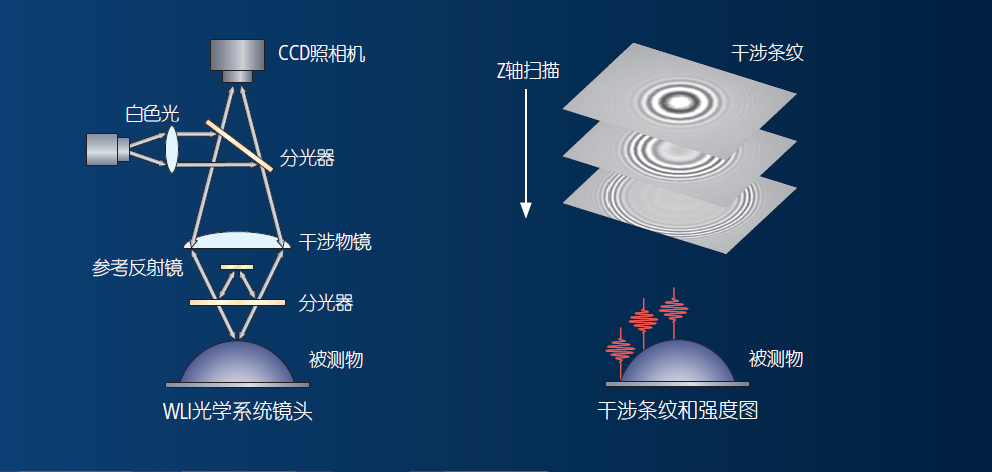
工作时,一束白色光被分为两束:一束射向干涉物镜内的参考反射镜,另一束投向被测物,两束反射光相遇产生干涉。当干涉物镜沿Z轴扫描时,仅在与被测物对焦的位置处才会产生白色干涉条纹。CCD相机捕捉条纹强度的峰值位置,经过算法运算,得出被测物的3D形状。
传统的接触式测量易划伤工件表面,尤其对芯片、光学元件等脆弱元件风险很高。WLI-Unit通过白光干涉原理,无需物理接触即可获取三维形貌数据,避免人为损伤,确保被测件完整性。
—— 高精度,满足纳米级检测 ——
Z轴分辨率可达4nm,且3D形貌可直观地呈现工件表面的微观起伏,实现平面度、台阶高度等三维分析,契合半导体、光学器件的纳米级检测需求。
—— 多元场景灵活适配 ——
经济型、模块化传感器组件:

复合型的高精度3D测量系统:
搭载白光干涉镜头的影像测量机QVWLI PRO QVWLI Pro是在影像测量机QUICK VISION的基础上,搭载白光干涉仪的复合型高精度3D测量系统。 一机两用,利用WLI光学系统获取的3D数据,实现三维表面性状与粗糙度分析,依据3D数据实现指定高度尺寸及截面形状测量。
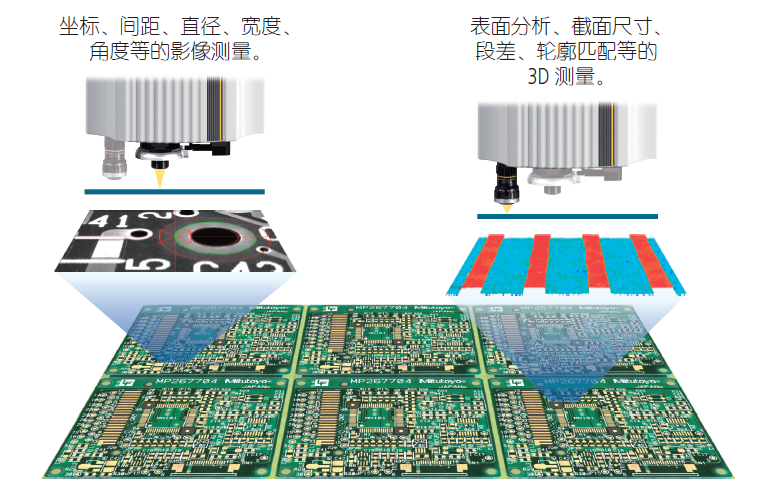
三丰的WLI白光干涉技术,凭卓越精度、非接触测量的优势与强大环境适应性,可在多领域微观测量大显身手。为您列举几个测量示例,带您进一步了解。
半导体封装基板:Via、线宽与间距、3D细微形状等
随着半导体性能提升,芯片封装技术受关注。WLI利用白色干涉原理,在封装工程中可测量Via、线宽与间距、3D表面粗糙度等细微形状,助力提升产品质量与可靠性。 ▼ 倒装芯片IC基板检测示意图: WLI可满足检测: • 封装基板的布线线宽与间距测量 • Via形状的三维解析 • 3D表面形状分析_表面平整度与微观缺陷检测等 金属薄膜:适用于表面分析、阶差测量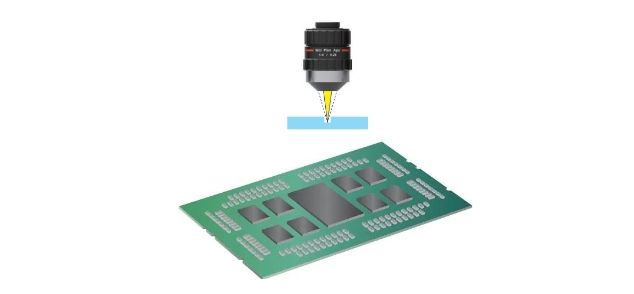
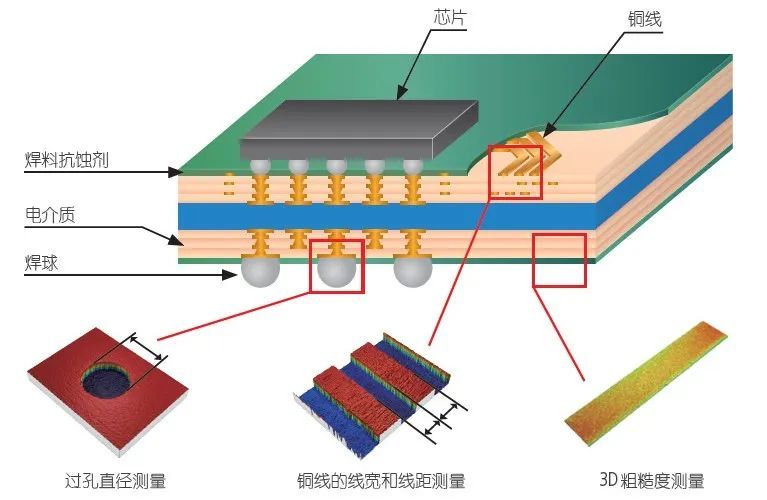
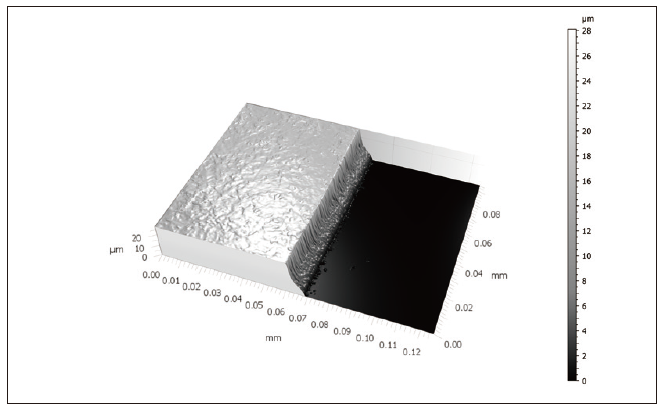
连接器:B to B连接器的断面形状、坐标位置、外径、高度测量
断面3D形状分析 坐标位置、外径、高度测量

微细精密加工部品 :实现断面形状精准测量

上一主题: 三丰三坐标CRYSTA-Apex V 系列助力高效测量
下一主题: 精密测量,实测好用的三丰测量工具盘点!






