QV HYPER Pro | 三丰仪器如何解决半导体倒装芯片测量难题
发布日期:2024年06月06日
浏览次数:1224
到2028年,半导体先进封装行业规模预计将达到674亿美元。
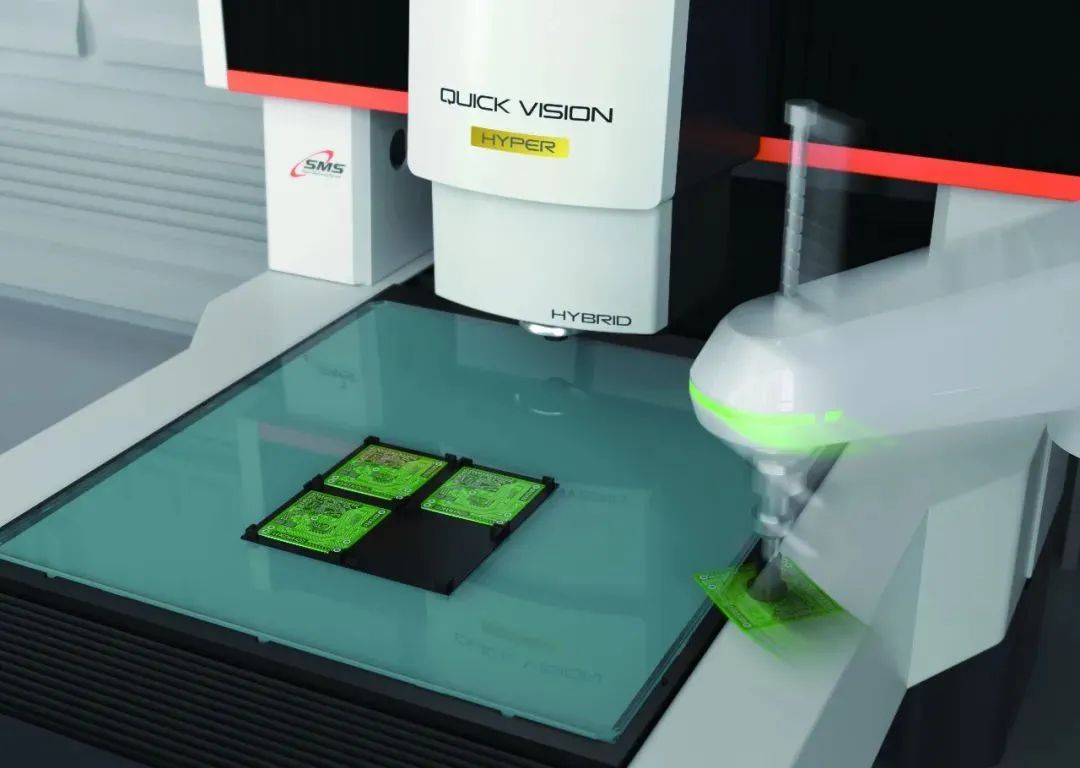
倒装芯片检测方案
工件用途
Purpose of the workpiece
倒装芯片将芯片上导电的凸点与线路板上的凸点进行连接,相连过程中,由于芯片的凸点是朝下连接,因此称为倒装。倒装芯片大量应用于高端物联网设备等电子产品中,是构建智能化产品的基础单元之一。
测量项目
Measurement items
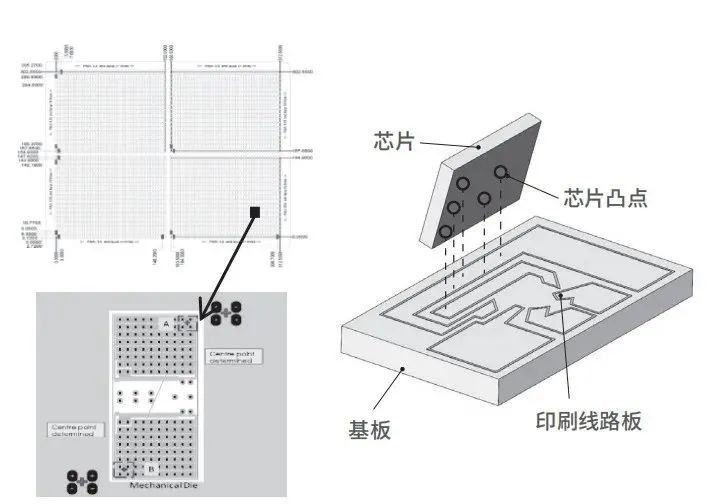
推荐机型

机器类别:
影像测量机
机器型号:
QV HYPER 404 Pro系列+STREAM 功能
测量软件:
QVPAK(影像测量机,用数据处理软件)
TAF功能高效对应坐标差检测
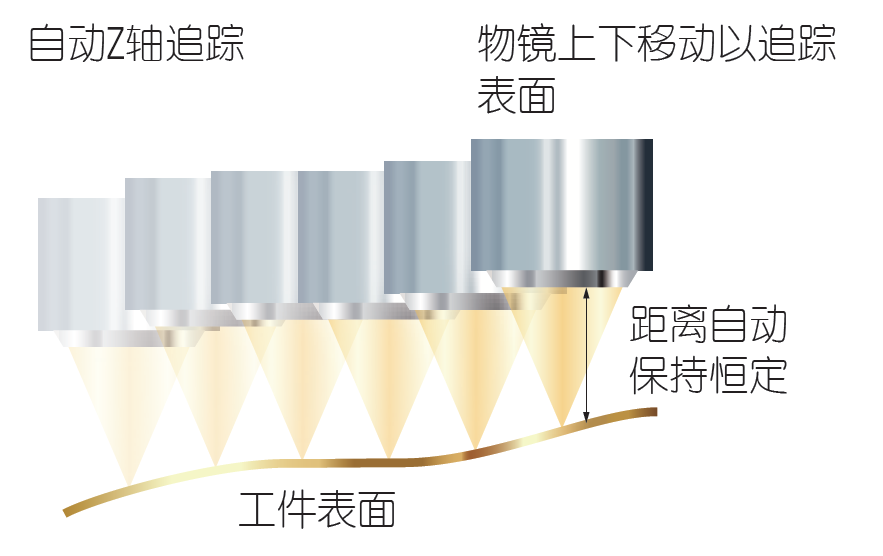
表面细微3D形状的高精度测量
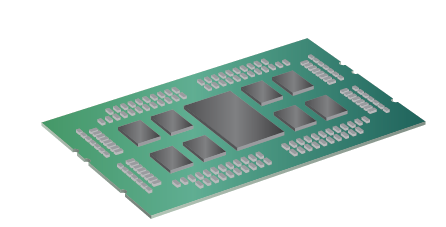
倒装芯片IC组件
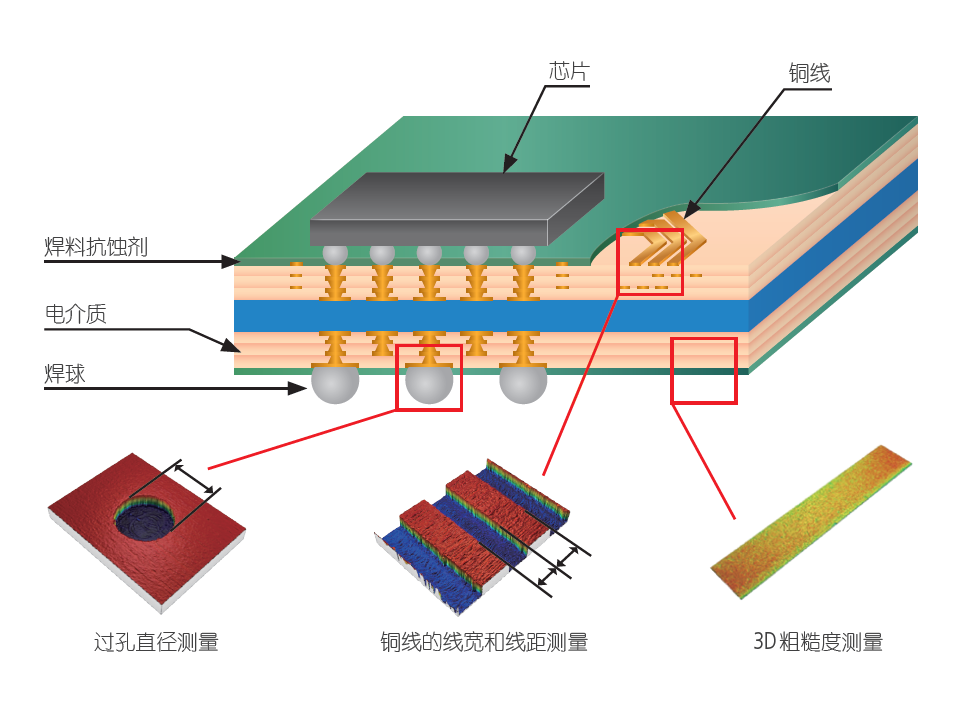
测量流程
Measurement process

测量时画面(图一)
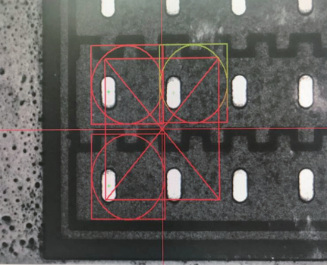
软件画面(图二)
上一主题: 模具篇 | 三丰仪器模具加工解决方案
下一主题: 三丰光栅测微仪案例 | 汽车制造领域的在线检测






